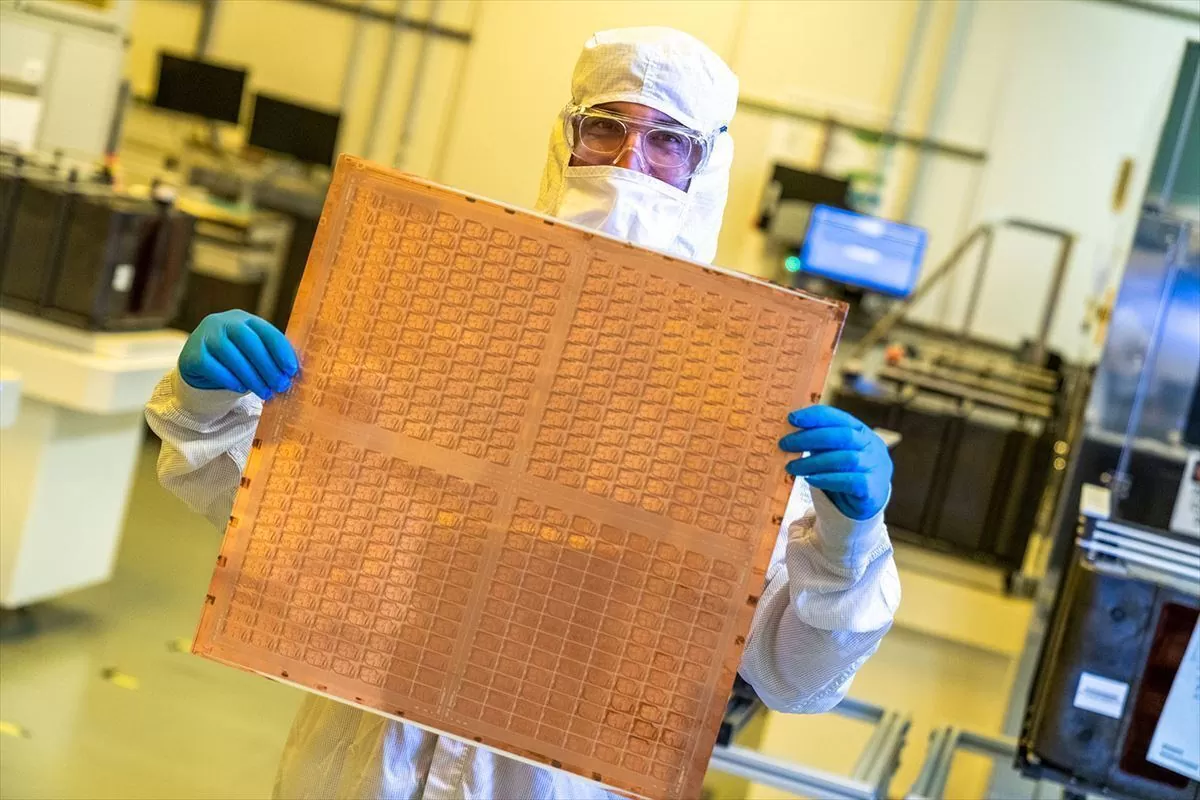
近日,在美国圣何塞举办的“Intel Innovation 2023”上,Intel公司详细介绍了Glass Core Substrate(玻璃基板)至今为止的开发情况。
在2023年5月突然召开的“Advanced Packaging”相关的在线说明会上,就提出将投入所谓新一代Glass Core Substrate(玻璃基板)。其特征是:
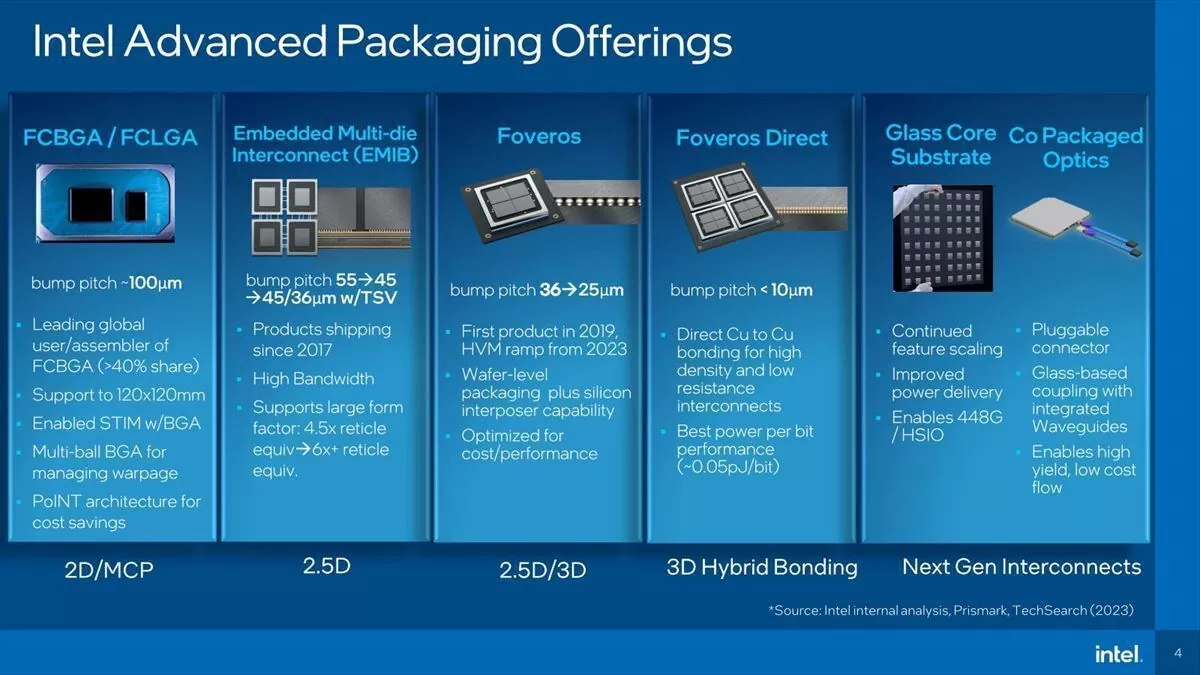
Photo01:这张幻灯片与之前发布会用的完全一样(色调有些许差别但内容没变)
其实,此次关于如何实现上述目标依旧没有公布,不过Intel明确表示在亚利桑那州的“Assembly and Test Technology Development factories”已经实际试制成功了(Photo02-06)。
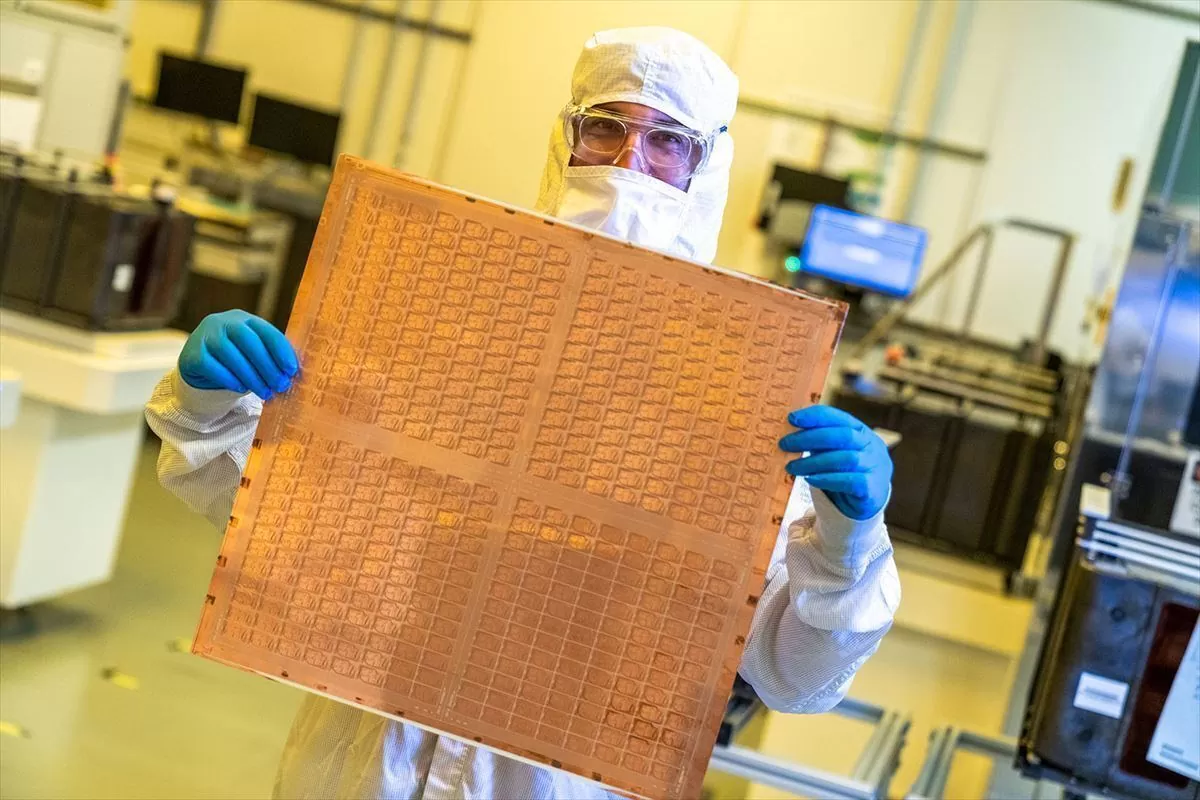
Photo02:试制出的Glass Core为基础的Substrate。1张基板可分出416个package。尺寸尚未明确,大概在500mm×500mm左右?
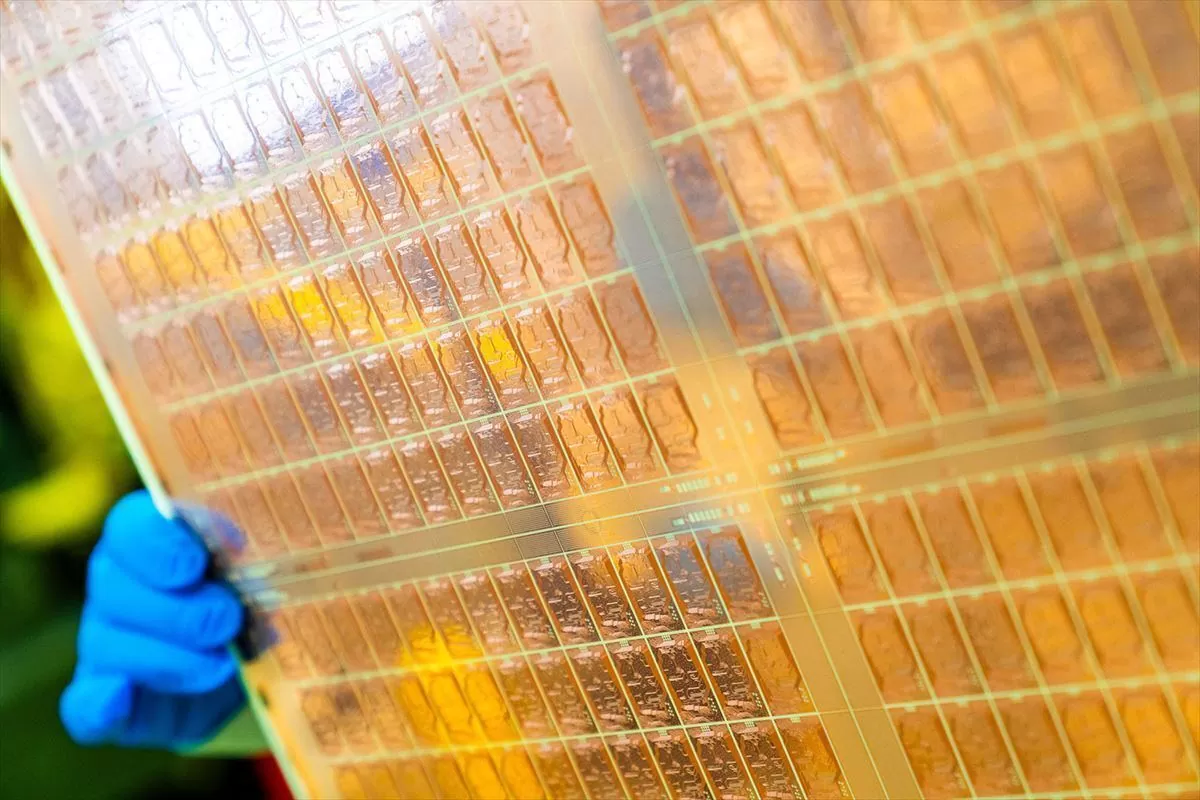
Photo03:package的放大图。背面依稀可见
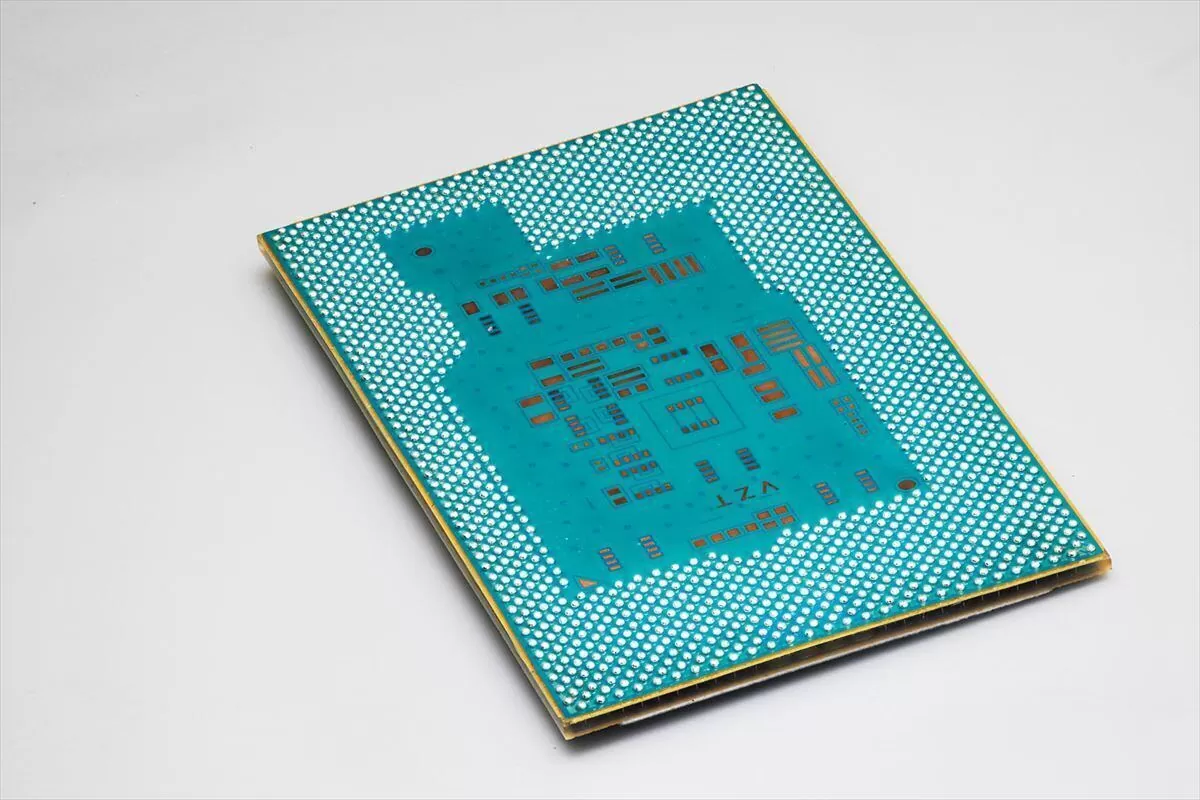
Photo04:试制package的背面。BGA package
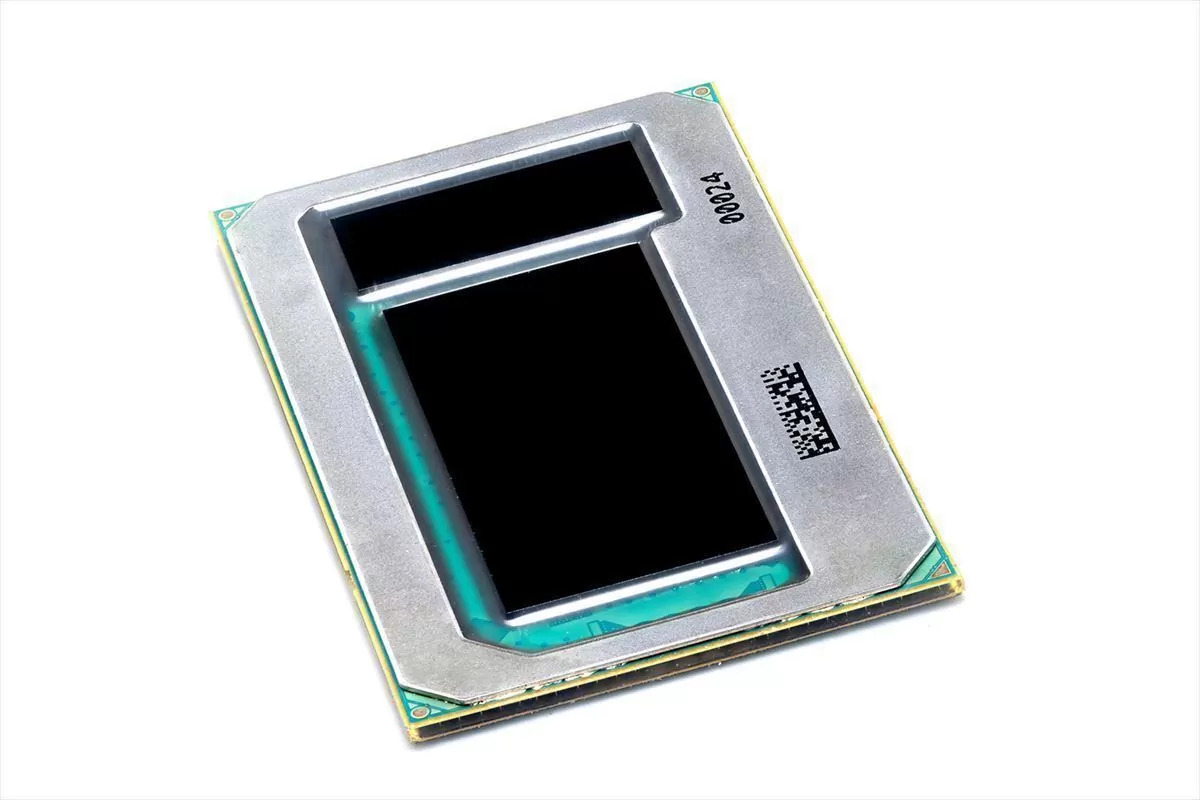
Photo05:正面。上覆某种芯片(可能是测试用模具)

Photo06:CVP&基底技术开发总监Hamid Azimi展示试制package
顺带一提,据Intel称此次试制是在今年7月做的,或许是经过了近2两个月的评估之后才在此次发布会上公开发表。
Intel表示,封装的基板Substrate本来就是以15年左右为周期更新迭代的,现在的主流Organic Package是在2000年代初期出现的。这么算起来确实是到了该更新换代的时候了。(Photo07)
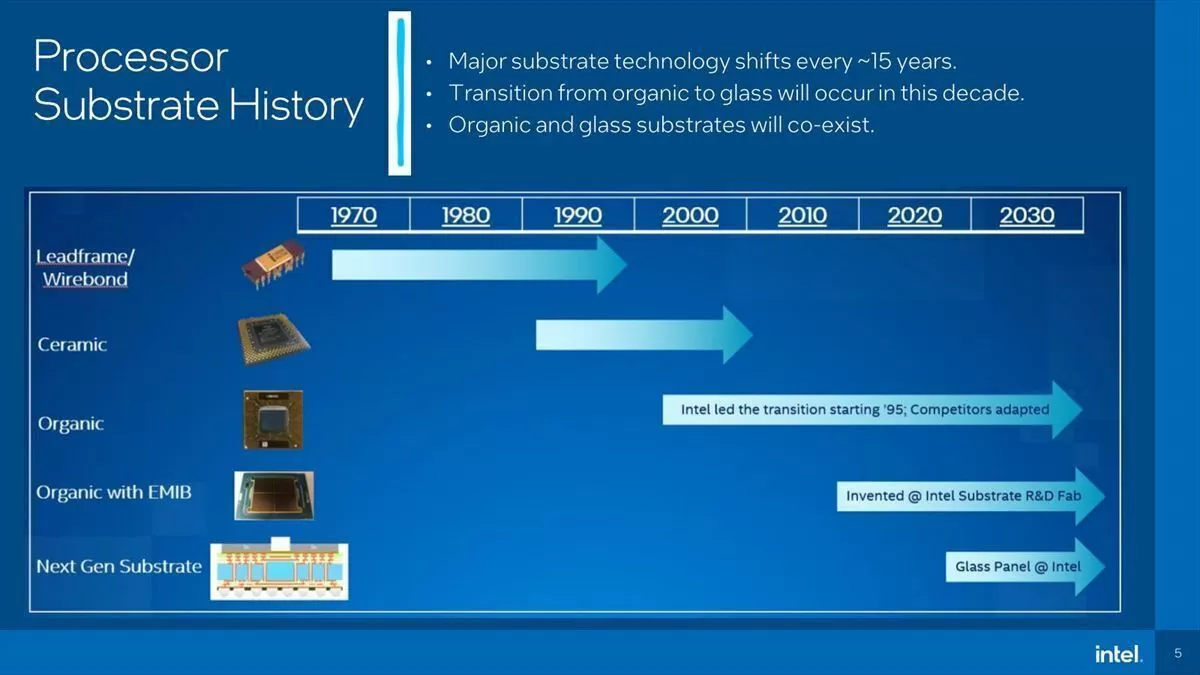
Photo07:虽然其中包含了EMIB,不过一般来说应该是以CoWoS为代表的2.5D方案
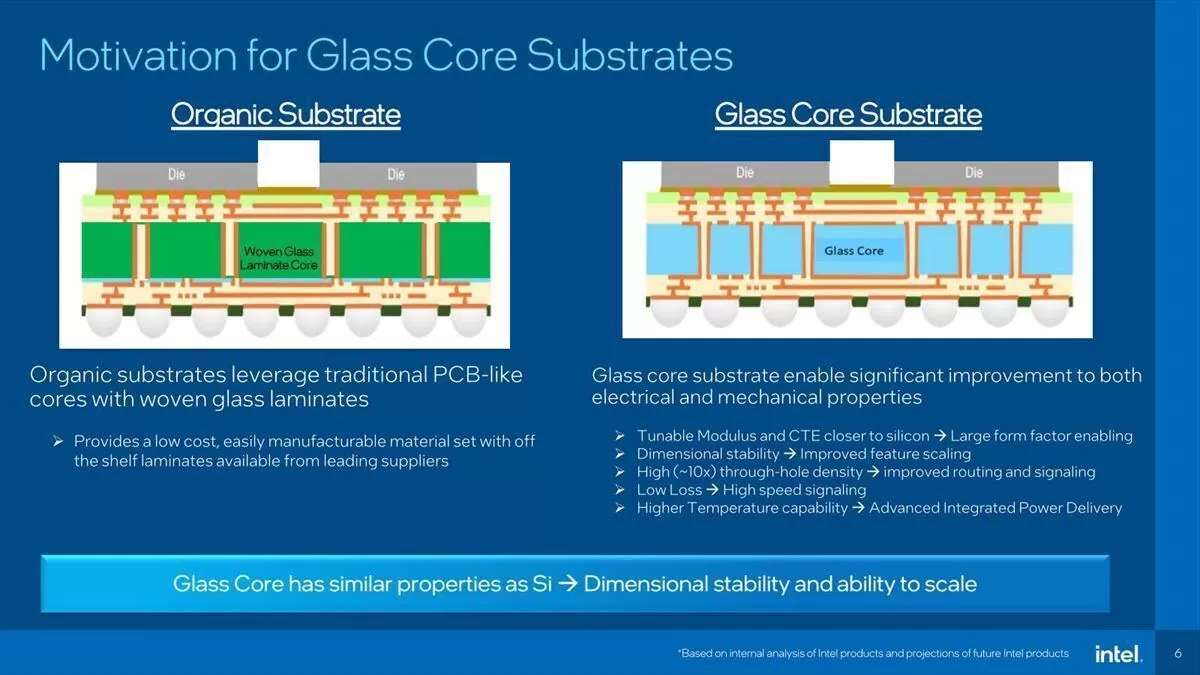
这种Glass Core Substrate与以往的Organic Substrate的区别在这里(Photo08)。
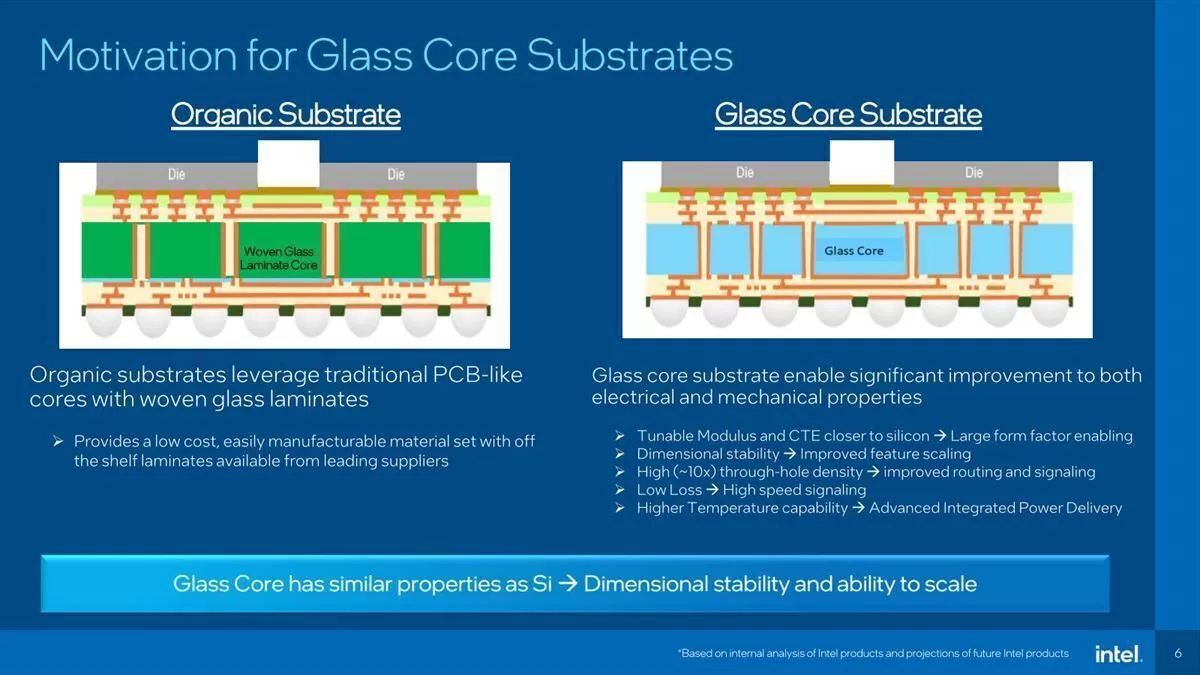
Photo08:不过,由于硬度高这一点导致了其很容易一损俱损的缺点,因此人们更想知道其机械强度或者说耐冲击性
由于玻璃和硅片的原材料都是硅元素,受热弯曲度接近,而且比Organic Package硬还不易变形,因此才能布更多的线路,对更高的温度也能适应。更详细介绍其特征的是这张(Photo09)中,可以构建更细小间距的线路,最大可适用于240mm×240mm的基板。
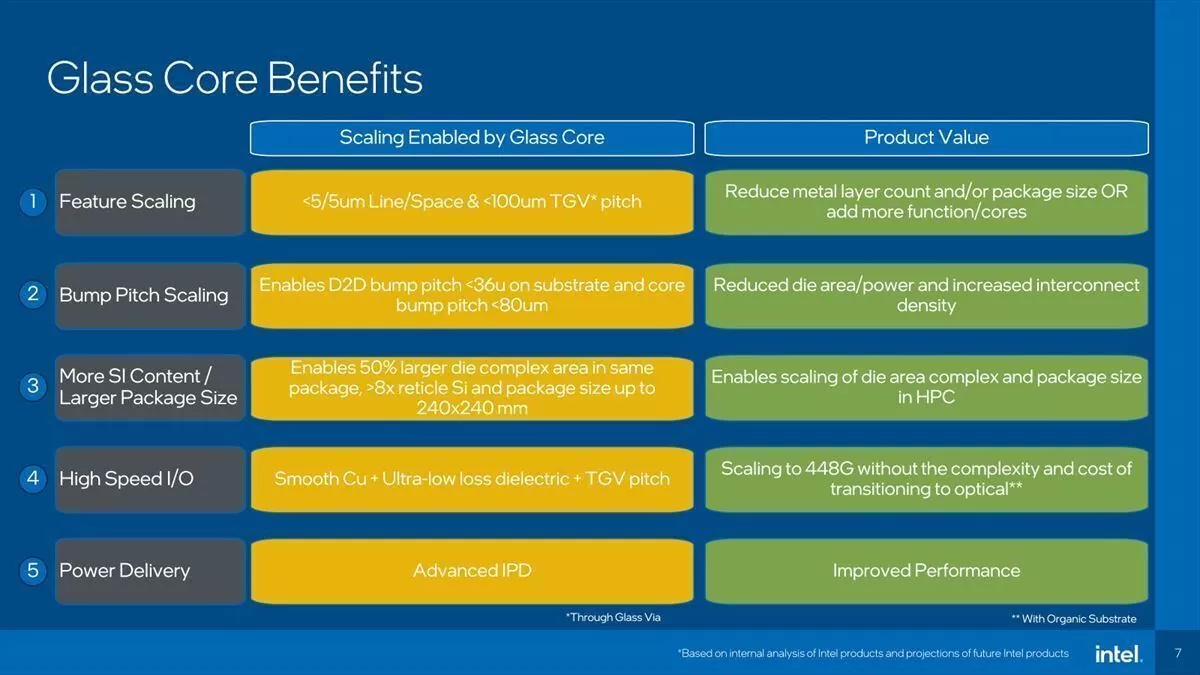
Photo09:Advanced IPD的里面不明。还有所谓信号可以达到448G,应该是说比Organic Package的导电率更低。现在连能传输多少距离都不清楚。
归根结底本次发布仍是处于R&D的级别,并不是说立刻就能将其作为IFS(Intel Foundry Services)的封装选择。(Photo10)
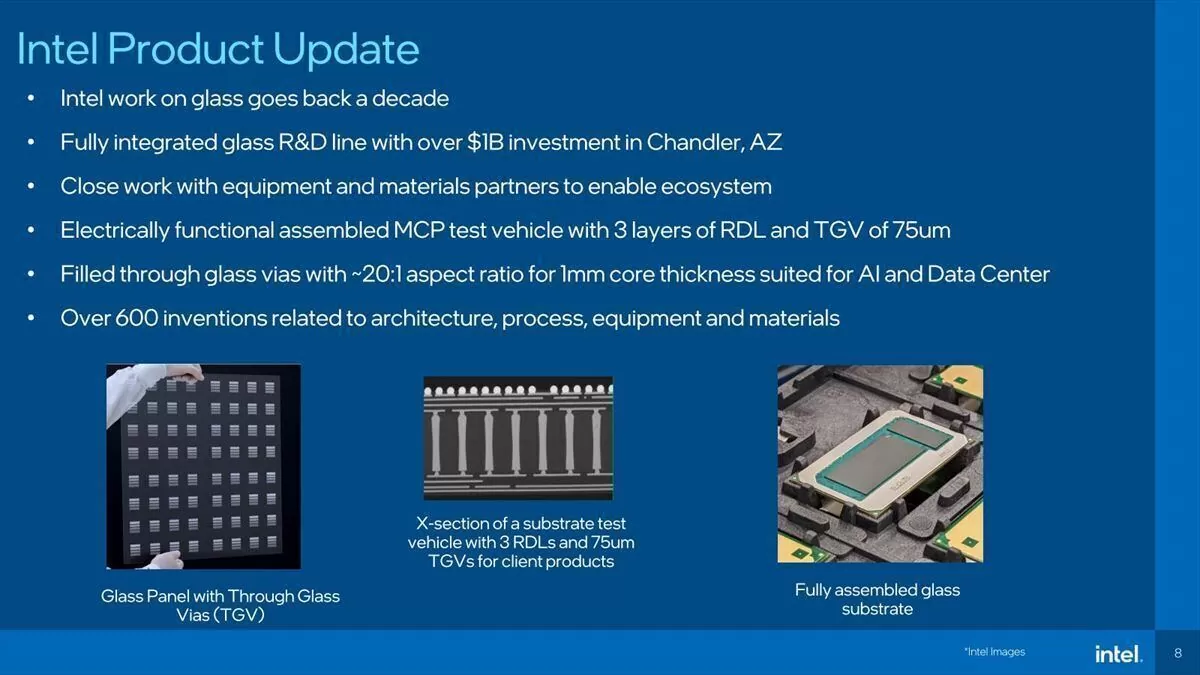
Photo10:RDL(Re-Distributed Layer)只有3层? 也就是说测试芯片目前也仅此而已。VIA的比20:1如果是接近量产水平的话还是相当优异的。
上一信息:半导体Device也可以用于碳中和?
Copyright © 2003-2036 北京三吉世纪科技有限公司Beijing CYCAD Century Science and Technology Co.,Ltd.版权所有 京ICP备14025030号-1 北京市开发区分局11030102011349